SiC substratų gamybos ir apdorojimo etapai yra tokie:
1. Krištolo orientacija:
Rentgeno spindulių difrakcijos naudojimas kristalo luitui orientuoti. Kai rentgeno spindulys nukreipiamas į norimą kristalo paviršių, difrakcinio pluošto kampas lemia kristalo orientaciją.
2. Išorinio skersmens šlifavimas:
Pavieniai kristalai, auginami grafito tigliuose, dažnai viršija standartinį skersmenį. Išorinio skersmens šlifavimas sumažina juos iki standartinių dydžių.
3. Galinio paviršiaus šlifavimas:
4 colių 4H-SiC substratai paprastai turi du padėties nustatymo kraštus – pirminį ir antrinį. Galinio paviršiaus šlifavimas atveria šiuos padėties nustatymo kraštus.
4. Vielos pjovimas:
Vielinis pjovimas yra esminis 4H-SiC substrato apdorojimo etapas. Įtrūkimai ir paviršiaus pažeidimai, atsiradę vielinio pjovimo metu, neigiamai veikia tolesnius procesus, pailgina apdorojimo laiką ir sukelia medžiagų nuostolius. Labiausiai paplitęs būdas yra kelių vielų pjovimas deimantiniu abrazyvu. 4H-SiC luitui pjauti naudojamas metalinių vielų, surištų deimantiniais abrazyvais, judesys.
5. Nusklembimas:
Siekiant išvengti kraštų atskilimo ir sumažinti sunaudojamų medžiagų nuostolius vėlesnių procesų metu, aštrios vielinio pjovimo drožlių briaunos yra nusklembtos iki nurodytos formos.
6. Retinimas:
Vielinis pjovimas palieka daug įbrėžimų ir paviršiaus pažeidimų. Retinimas atliekamas naudojant deimantinius ratus, kad šie defektai būtų kuo labiau pašalinti.
7. Šlifavimas:
Šis procesas apima grubų ir smulkų šlifavimą, naudojant mažesnio dydžio boro karbidą arba deimantinius abrazyvus, kad būtų pašalinti likutiniai pažeidimai ir nauji pažeidimai, atsiradę retinimo metu.
8. Poliravimas:
Paskutiniai etapai apima grubų poliravimą ir smulkų poliravimą naudojant aliuminio oksido arba silicio oksido abrazyvus. Poliravimo skystis suminkština paviršių, kuris vėliau mechaniškai pašalinamas abrazyvais. Šis žingsnis užtikrina lygų ir nepažeistą paviršių.
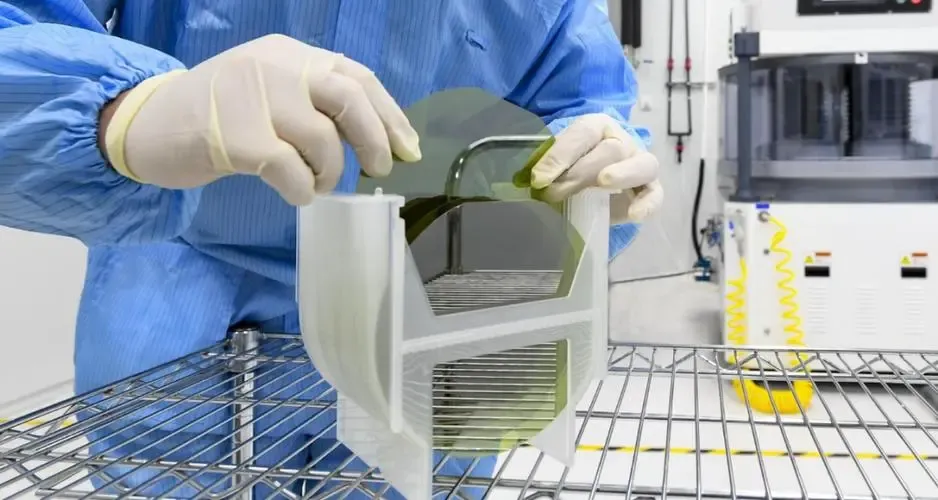
9. Valymas:
Dalelių, metalų, oksidų plėvelių, organinių likučių ir kitų apdorojimo etapų likusių teršalų pašalinimas.
Paskelbimo laikas: 2024-05-15